随着材料技术的发展,InAs/GaSbⅡ类超晶格(T2SLs)的优越性日益凸显,特别适用于中长波红外(MLWIR)和甚长波红外(VLWIR)探测。基于InAs/GaSb T2SLs的光电探测器因具有俄歇复合速率较低、载流子寿命相对较长、以及吸收系数大等特点,在气象监测、资源勘探、医疗诊断、农业等传感应用中发挥着关键作用。尤其是大尺寸红外焦平面阵列(FPA)具有更大的视场、更高的角度分辨率,适合于现场跟踪和监视应用,一直倍受人们关注。
据麦姆斯咨询报道,近期,昆明理工大学理学院和云南大学物理与天文学院的科研团队在《红外技术》期刊上发表了以“InAs/GaSb Ⅱ类超晶格长波红外探测器研究进展”为主题的文章。该文章第一作者为昆明理工大学田亚芳实验师,通讯作者为云南大学史衍丽研究员。
本文在深入调研InAs/GaSb T2SLs长波红外探测器结构的发展基础上,系统报道了以GaSb为衬底和以InAs为衬底探测器的结构设计研究进展,从暗电流密度、量子效率(QE)、响应波长等器件性能角度方面对比分析了各种结构的优缺点。
基于GaSb的T2SLs探测器
以GaSb为衬底的长波红外探测器结构有PIN、PBIBN、NBN以及PBN型等,其吸收区材料有InAs/GaSb SLs,也有InAs/InAsSb SLs。
图1给出了在GaSb衬底上生长的PIN结构。该结构依次包含1 μm的N型InAsSb层、50个周期的Si掺杂的13ML InAs/7ML GaSb SLs、无掺杂的2.5 mm的13ML InAs/7ML GaSb SLs吸收区、50周期的Be掺杂的13ML InAs/7ML GaSb SLs和50 nm的Be掺杂GaSb层。顶部Be掺杂的P-GaSb和底部Si掺杂的N-InAsSb用作电接触层。
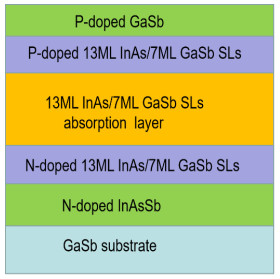
经K⋅P模型计算,在77 K温度时,-50 mV的反向偏压下,该器件的暗电流密度为4.3×10⁻⁵ A/cm²。研究表明,低偏压下器件的暗电流主要因产生-复合过程而形成,高偏压下主要由隧穿电流构成。在77 K下50%截止波长只有8 μm,且量子效率低于15%。这是因为该结构中载流子寿命很短(约1.5 ns),光生载流子的扩散长度也较短。
产生-复合和隧穿暗电流与带隙相关,可以通过将较宽的带隙材料插入空间电荷区来有效地抑制它们。特别对于InAs/GaSb SLs材料,可以利用InAs/GaSb/AlSb等异质结构能带工程设计不同的势垒结构,在有效抑制T2SLs中暗电流的基础上提高量子效率。基于T2SLs本征材料的带电性能和补偿掺杂,Chen Jianxin团队通过MBE生长技术,引入电子势垒层和空穴势垒层,设计出具有双势垒结构PB₁IB₂N光电探测器,其结构如图2(a)所示。
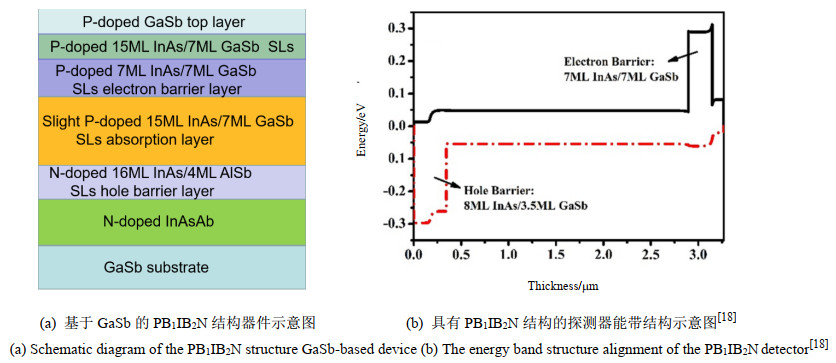
在GaSb衬底上生长1.5 μm厚的Si掺杂的N型InAs0.91Sb0.09刻蚀停止层;然后是80周期的N型掺杂的16ML InAs/4ML AlSb SLs空穴势垒区B₁,紧跟着是300周期轻P型掺杂的15ML InAs/7ML GaSb SLs吸收区,和60周期的P型掺杂的7ML InAs/7ML GaSb SLs电子势垒区B₂;最后是Be掺杂的25周期的15ML InAs/7ML GaSb SLs作为能带接触缓冲层,和0.05 μm厚的Be掺杂GaSb作为顶部接触层。
图2(b)为双势垒PB₁IB₂N探测器结构的全能带结构图。从K⋅P模型计算得到,InAs/AlSb空穴势垒层的能带隙为459 meV,与吸收层的导带偏移为零,即相对于吸收层的价带偏移约为356 meV。
经测试该PB₁IB₂N结构的探测器在80 K下的100%截止波长为12.5 μm,这是覆盖长波红外大气窗口的技术重要波长。虽然暗电流密度在80 K、-50 mV的反向偏压下为1.1×10⁻³ A/cm²,动态微分电阻面积乘积(RA)为14.5 Ωcm²,但是其量子效率提高到了30%,且比探测率D*为1.4×10¹¹ m·Hz1/2·W⁻¹。
除了InAs/GaSb T2SLs外,InAs/InAs₁₋ₓSbₓ T2SLs已被证明比InAs/GaSb具有更长的载流子寿命,并已被提出作为红外光电探测器的替代方案。与InAs(a=6.0584Å)和GaSb(a=6.0959Å)相比,InAs和InAs₁₋ₓSbₓ(InAs0.45Sb0.55的晶格常数a=6.3250Å)化合物不是紧密晶格匹配的,其组成层厚度的改变必须仔细考虑InAs₁₋ₓSbₓ层,在需要大量Sb的LWIR和VLWIR体系中尤其如此。因此,设计器件结构时,在保障探测器有较高的吸收系数基础上,必须提供良好的应变平衡,以确保高质量的材料具有较长的少子扩散长度,从而实现高量子效率;此外,还需设计一个高度可控的势垒,有效阻挡导带中的大多数电子的同时,确保价带中少数空穴的自由移动。为解决上述问题,可以在超晶格中加入含Sb组分较大的(x>0.5)的InAs₁₋ₓSbₓ合金,同时降低InAs厚度,并通过模拟计算精确控制应变平衡,这可以增加电子空穴波函数的交叠,从而得到较大的吸收系数;另外,为了在导带中产生势垒,在InAs中间插入一层薄薄的AlAs,由于AlAs(a=5.6622Å)与InAs(a=6.0584Å)材料之间有6.5%的晶格失配,只能使用一个或两个单层组成的薄层。
基于上述分析,在抑制暗电流的基础上提高量子效率和探测率,对于GaSb为衬底的探测器,USA西北大学提出了吸收区为InAs/InAs₁₋ₓSbx材料的NBN(PBN)结构的探测器。在Te掺杂的N型GaSb晶圆上以MBE方式生长0.1 μm的GaSb缓冲层和0.5 μm N掺杂InAs0.91Sb0.09缓冲层,以使表面光滑;然后是0.5 μm的N+接触层;接着是6 μm的轻掺杂N型吸收区,其材料由每周期28ML InAs/7ML InAs0.45Sb0.55的SLs组成,再是0.5 μm势垒层,其材料由每周期6/2/6/7ML的InAs/AlAs/InAs/InAs0.45Sb0.55 SLs组成;最后是0.5 μm的N接触层。N接触超晶格的设计类似于吸收区SLs的设计,采用Si作为N型掺杂剂。该NBN结构如图3所示。
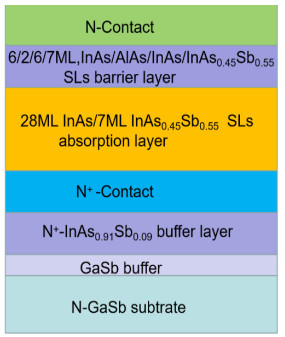
图4为该NBN结构探测器的能带结构及工作原理示意图。从图(a)中可以看出InAs/AlAs/InAs/InAs0.45Sb0.55 SLs势垒阻止了大多数电子的输运,同时允许少数空穴和光生载流子从左边的有源区域扩散。即在具有势垒层的超晶格中,产生了能带对齐和有效带隙。图(b)中的彩色矩形表示材料的禁带宽度。
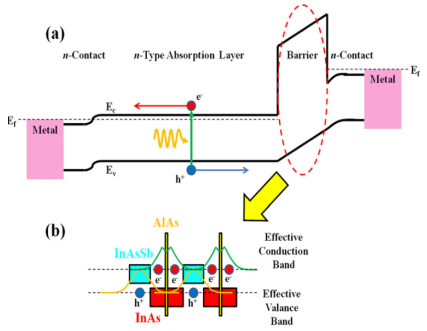
经测试,该NBN结构的探测器在77 K时具有10 μm的50%截止波长,且其暗电流密度在77 K和-90 mV偏置电压下为4.4×10⁻⁴ A/cm²,而-90 mV是器件量子效率饱和的偏置电压。动态微分电阻面积乘积RA在-90 mV偏置时达到其局部最大值119 Ωcm²。在正面光照和没有应用任何抗反射(anti-reflection)涂层的情况下,该探测器在77 K时的饱和量子效率高达54%,这证实了材料的高质量,同时表明量子效率仍随着器件厚度的增加而增加,此时不受少子扩散长度的限制。另外,该探测器的探测率为2.8×10¹¹ cm·Hz1/2·W⁻¹,且在-70~-90 mV时保持相对稳定。很显然,该NBN结构探测器的综合性能明显高于之前所述的InAs/GaSb SLs探测器,这使得其成为LWIR红外成像应用的理想选择。
基于InAs的T2SLs探测器
尽管取得诸多进展,InAs/GaSb T2SLs光电探测器仍然存在少数载流子寿命短的问题。研究表明,T2SLs结构中少数载流子寿命短主要是由Shockley-Read-Hall(SRH)复合引起的,而SRH复合又是由材料缺陷引起的。因此,对于器件应用而言非常迫切需要生长具有高晶体完美度的低缺陷超晶格材料。传统的InAs/GaSb超晶格大多生长在GaSb衬底上,由于InAs在GaSb衬底上受到拉伸应变,通常在InAs/GaSb界面上插入InSb单分子层来平衡应变。此外,基于GaSb的InAs/GaSb SLs的典型生长温度约为400℃,如此低的生长温度是缺陷密度高和少数载流子寿命短的主要原因。
为了获得高质量的T2SLs材料并提高SRH寿命,开始了基于InAs衬底的InAs/GaAsSb SLs探测器的研究。通过在InAs衬底上生长T2SLs材料,不需要刻意的界面设计来平衡层之间的应变,这更容易生长高质量的材料,且能够显著提高T2SLs材料的生长温度(约480℃)。较高的生长温度有利于促进二维外延,提高晶体质量,还可以有效降低SRH复合概率,提高少数载流子寿命。同时,InAs层厚度主要决定了T2SLs探测器的截止波长,通过在InAs衬底上生长SLs,在每个周期内增加InAs层厚度以扩大截止波长将非常简单。因此,基于InAs的InAs/GaAsSb SLs可以作为长波长和超长波长红外探测器的另一种材料选择。
为了进行应变补偿,Chen Jianxin团队在GaSb层中引入9%的As,得到与InAs衬底晶格匹配的GaAs0.09Sb0.91三元化合物。在480℃温度下,采用MBE技术在未掺杂的N型InAs衬底上生长的T2SLs器件,其结构从下到上依次为:首先是1.0 μm厚的Si掺杂InAs缓冲层,然后是0.5 μm厚的Si掺杂20ML InAs/9ML GaAsSb SLs,接着是2.5 μm厚的非掺杂20ML InAs/9ML GaAsSb SLs吸收区,最后是0.5 μm厚的Be掺杂20ML InAs/9ML GaAsSb SLs,并在其表面覆盖50 nm掺Be的GaSb接触层。该PIN结构如图5(a)所示。
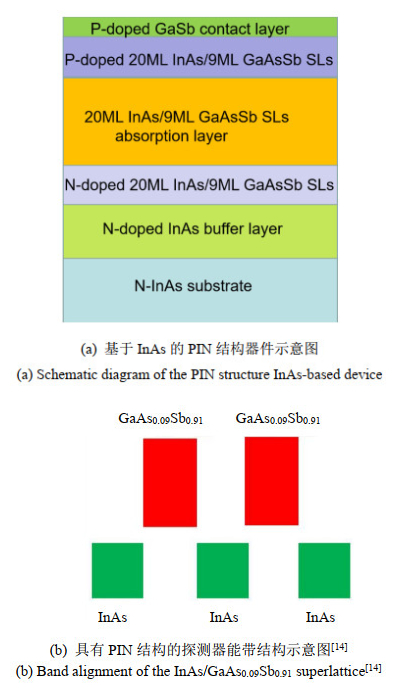
应用K⋅P模型计算InAs/GaAs0.09Sb0.91超晶格的能带结构如图 5(b)所示,InAs导带底部位于GaAs0.09Sb0.91价带顶部下方,带偏移能量为70 meV。因此,InAs/GaAs0.09Sb0.91异质结构仍然保持“断隙”的Ⅱ类超晶格能带结构,这使得我们可以通过使用与InAs/InAsSb超晶格相比相对较薄的InAs层来实现截止波长。
经测试,该PIN结构器件在80 K时具有10 μm的50%截止波长,且其暗电流密度和零偏置电阻面积(R₀A)在80 K和-30 mV偏置电压下分别为4.01×10⁻⁵ A/cm²、36.9 Ωcm²。很明显,在相同器件结构、暗电流密度相当的情况下,基于GaSb的PIN器件的50%截止波长要比基于InAs的PIN器件的短2 μm。可以预见,在截止波长相同且工作温度也相同的情况下,基于GaSb的PIN器件的暗电流密度要比基于InAs的PIN器件的高许多。其原因在于,基于InAs的器件的载流子寿命(10 ns)比基于GaSb的(1.5 ns)器件高出近7倍,而基于InAs的器件的缺陷密度比基于GaSb的器件低了一个数量级以上。所以,基于GaSb器件的产生-复合电流密度远远大于基于InAs器件的GR电流密度,GaSb基器件的高陷阱辅助隧穿电流主要是由于其缺陷密度高于InAs基器件。另外,该器件在80 K时量子效率为45%左右,探测率为7.4×10¹⁰ cm·Hz1/2·W⁻¹。
随着外延和制造技术的发展,在以上的PIN结构基础之上,2020年该团队的Huang Min等人对以InAs为衬底、器件结构PB₁IB₂N(PB1ΠB2N)的InAs/GaAsSb长波红外探测展开了研究,并研制出了大尺寸(320×256)高性能的FPA。在80 K时,该探测器100%截止波长为9.5 μm,在-0.02 V偏压下器件显示出1.7×10⁻⁵ A/cm²的均匀暗电流和1.5×10³ Ωcm²的动态微分电阻面积(RA)。在400 μs积分时间、300 K背景和F/2.0光学条件下,FPA的噪声等效温差和可操作性分别为20.7 mK和99.2%。该高性能FPA进一步验证了基于InAs的InAs/GaAsSb T2SLs在LWIR检测中的可行性。
由于GaSb和InAs的材料性质,以上这些利用InAs衬底作为N接触的器件自然采用了P-on-N极性结构。然而为了匹配读出电路(ROIC)的不同极性,还应设计基于InAs衬底的N-on-P极性的器件结构。此外,InAs/GaSb T2SLs长波红外探测器器件除了以MBE的方式生长外,还可以以金属有机化学气象沉积(MOCVD)的方式生长,且该方式的生长温度高(530℃),有利于生长高质量的器件材料。2020年中科院苏州纳米研究所的Teng Yan等人报道了利用MOCVD在InAs衬底上生长InAs/GaSb T2SLs,实现了具有N-on-P极性的高性能长波红外探测器,以满足不同外围电路的需求。在MOCVD生长的InAs基InAs/GaSb T2SLs探测器中,锌(Zn)被作为P型掺杂剂,但由于其高扩散率可能会破坏异质结并降低器件性能(造成高泄漏电流),因此在P型区域生长后插入未掺杂的T2SLs间隔层,以防止Zn扩散到势垒层。
通过MOCVD生长在InAs衬底上的具有N-on-P极性的InAs/GaSb器件结构如图6所示,从下到上依次包含:200 nm厚的P-MWSL接触层(P=1×10¹⁸ cm⁻³),200 nm厚的未掺杂的MWSL间隔层,200 nm厚的N-MWSL势垒层(N=2×10¹⁶cm⁻³),1.0 μm厚的N-LWSL吸收区(N=2×10¹⁶ cm⁻³),最后是20 nm厚的高掺杂顶部接触层(N=1×10¹⁸ cm⁻³)。其中,P-MWSL和N-MWSL由6ML InAs/8ML GaSb SLs组成,截止波长为4 μm;N-LWSL吸收区由20ML InAs/8ML GaSb SLs组成,截止波长为10 μm。
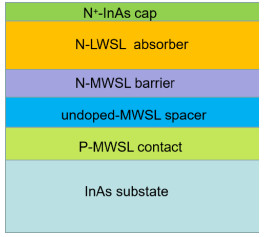
经测试,该N-on-P极性的器件在80 K时100%截止波长为12 μm,-0.1 V偏压下,暗电流密度为6.0×10⁻⁴ A/cm²,探测率为8.3×10¹⁰ cm·Hz1/2·W⁻¹。可见,该器件表现出了与P-on-N器件相当的性能。但是,其量子效率并不高(24%)。
量子效率和暗电流的改进
对于LWIR光电探测器来说,量子效率和暗电流是实现高探测率的两个关键参数。T2SLs光电探测器电学性能虽然可以通过增加势垒层的结构设计而得到很大的改善,但仍存在吸收系数有限、反射损失等问题,这使得难以实现高量子效率,同时还需要尽可能地减小暗电流。为了提高器件性能,除了以上从器件结构设计上进行优化之外,还可以从物理光学的角度引入微结构设计,同时从制备工艺方面进行优化,如刻蚀,以提高器件性能。
为提高器件的量子效率,Zhou Yi等人通过实验和模拟计算的方法,研究一组不同吸收区厚度的基于InAs衬底的InAs/GaAsSb T2SLs LWIR探测器时,观察到了高量子效率(高于65%)。研究发现增强的光学响应主要归因于高N掺杂InAs缓冲层与T2SLs之间的折射率差异,引起多重反射和双层薄膜干涉,形成谐振腔效应,这不仅增加了入射光的传播路径,而且在某些波长处大大降低了表面反射损失,从而导致光在SLs材料中的收集,并有效地增强光吸收。此外,该研究工作通过调整InAs缓冲层的掺杂浓度进一步降低缓冲层的折射率,成功实现了一个高QE(大于65%)的基于InAs的T2SLs LWIR探测器,该探测器吸收区域薄至3.55 μm,且没有任何AR涂层。该研究结果提供了一种简单而有效的方法来提高薄膜光电探测器的光学吸收,尤其是对于吸收系数低的材料。此基于InAs的InAs/GaAsSb探测器为如图7所示的PBIBN结构。
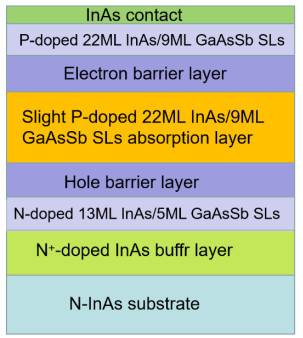
在480℃温度下,以MBE方式在N型InAs衬底上生长1.2 μm Si掺杂(N=2×10¹⁸ cm⁻³)的InAs缓冲层,然后是35周期Si掺杂(N=1.5×10¹⁷ cm⁻³)的13ML InAs/5ML GaAsSb N型SLs,一个空穴势垒和梯度势垒,3.55 μm厚的Be掺杂(N=2.5×10¹⁵ cm⁻³)的22ML InAs/9ML GaAsSb SLs吸收区,一个电子势垒和20周期Be掺杂(P=1×10¹⁷ cm⁻³)的22ML InAs/9ML GaAsSb P型SLs,最后在其顶部添加一薄的Be掺杂(P=1×10¹⁸ cm⁻³)InAs接触层。
除了以重掺杂缓冲层的方式在缓冲层与T2SLs之间形成大的折射率差、引起多重反射和双层薄膜干涉、从而有效地增强光吸收之外,还可以采用物理气相沉积(PVD)方法在去除衬底之后的缓冲层表面沉积多层薄膜,使探测器与多层薄膜结合形成F-P腔共振,通过入射光与探测器的耦合激发共振效应,能调控器件50%的截止波长;同时,多层薄膜也会影响入射光在器件表面的反射,从而提高了器件光谱响应。由于硫化锌(ZnS)和锗(Ge)或它们的组合对长波红外辐射没有吸收或吸收微弱,因此长波InAs/GaSb T2SLs红外FPA的设计和生长多采用由ZnS和Ge组成的多层薄膜结构。
SHI Rui等人通过仿真与实验的方法建立的多层膜结构的器件模型如图 8所示。在该模型中,采用完全匹配层(PML)作为分析电磁散射问题的吸收边界条件,且在相邻像素之间使用周期边界条件。器件的电极材料为金(Au),本征吸收材料为14ML InAs/7ML GaSb的T2SLs,采用PVD方法在InAsSb缓冲层表面沉积了由ZnS和Ge组成的多层涂层。实验表明,与没有多层薄膜的FPA相比,多层薄膜使其响应峰位置从8.7 μm和10.3 μm扩展到9.8 μm和11.7 μm,50%响应截止波长从11.6 μm移动到12.3 μm,并且在波长为12 μm处的响应强度增加了69%。可见,优化的多层薄膜不仅可以调控FPA的响应波长,还可以增强光谱响应,这种微结构设计为实现更高灵敏度和更高成像能力的长波红外探测器提供了更好的平台。
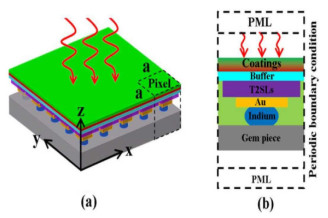
InAs/GaSb T2SLs虽然被认为是第三代高性能LWIR探测器FPA的最佳候选材料,但FPA的台面型结构使得探测器表面电流不可忽视,该表面电流是暗电流的重要组成部分。表面电流来自于探测器侧壁表面,被认为是来自于台面形成过程中周期性晶体结构的突然终止,导致侧壁表面附近的能带弯曲,使得多数载流子积聚或电导率类型反转。湿法刻蚀和干法刻蚀均可用于InAs/GaSb超晶格FPA的台面形成,而消除壁面游离Sb和GaSb是优化刻蚀工艺的关键。研究认为,在湿法刻蚀过程中,游离Sb会在表面形成,从而在表面产生电流通道;而电感耦合等离子体(ICP)干法刻蚀由于其各向异性,在刻蚀过程中能去除游离的Sb和GaSb,从而减少暗电流,且提高ICP的温度有助于刻蚀副产品汽化,防止游离Sb和GaSb在侧壁表面形成。此外,在170℃的ICP刻蚀不仅可以使器件暗电流密度降到1×10⁻⁵ A/cm,而且还能得到接近垂直的光滑侧壁,这对于具有小像素间距的大阵列FPA是非常必要的。
综上所述,基于GaSb与基于InAs的InAs/GaSb T2SLs长波红外探测器,目前基本上有以上5种典型器件结构及相应材料参数。不同的材料和不同的结构参数,对应于不同器件性能。基于以上5种典型器件结构及相应材料参数,整理性能参数对比如表 1所示。表中所有性能参数均是在75~80 K温度范围内测得。需要特别说明的是,InAs-substrate的PB₁IB₂N结构的探测器暗电流密度和量子效率是器件经过了微结构处理和ICP刻蚀工艺之后测得的。
表1 不同结构的GaSb/InAs探测器性能参数对比
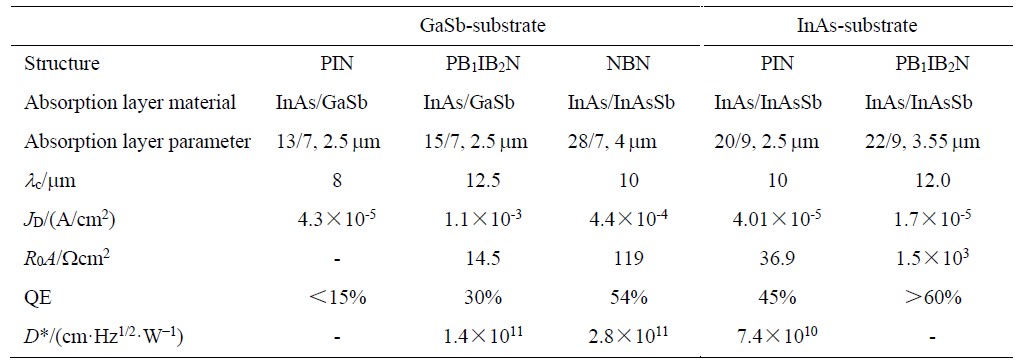
从表中可以看出,对基于GaSb的探测器而言,PB₁IB₂N结构器件的量子效率高出PIN结构器件的一倍,但同时其暗电流密度明显增大;而NBN结构探测器的综合性能显著高于前两者。此外,InAs/GaSbⅡ类超晶格长波红外探测的结构,从最初的以GaSb为衬底的PIN结构发展到现在的以InAs为衬底的PB₁IB₂N结构,其截止波长、暗电流密度及量子效率均有显著的改善。产生这一现象的主要原因是在InAs衬底上生长T2SLs材料时,不需要刻意的界面设计来平衡层之间的应变,这使得生长高质量的材料相对于在GaSb衬底上的更容易,且能够提高T2SLs材料的生长温度,较高的生长温度有利于促进二维外延,提高晶体质量;同时,InAs层厚度主要决定了T2SLs探测器的截止波长,通过在InAs衬底上生长SLs,在每个周期内增加InAs层厚度以扩大截止波长也变得相对简单。
发展趋势
InAs/GaSb T2SLs长波红外探测器在短短十几年内取得了快速发展,随着新型器件结构的创新、材料生长技术的优化和器件制备工艺的完善,InAs/GaSb T2SLs红外探测器在性能提升、高温工作、多色探测等方面将得到进一步的发展:
1)生长机理探索,MBE生长技术优化。InAs/GaSb T2SLs长波红外探测器性能主要受制于材料质量而非理论预测。面对AlSb、GaSb、InSb等Sb化物的反常生长速率,探索Sb化物的MBE生长机理已成为提高器件性能亟待解决的问题;同时需要进一步优化MBE生长技术,提高生长温度,降低材料缺陷密度,提升材料的生长质量,从而降低器件的暗电流和提高量子效率。
2)采用光学调控,发展钝化技术。除了在能带结构及材料生长领域进行不断的研究以优化器件性能外,光学调控也是非常有效的一种方法。光学调控通常采用表面微纳结构,如光子晶体、陷光结构、表面等离子体增强等,调控入射光的空间分布,提高器件对红外光的吸收和相应光谱的变化;另外,还需发展新型钝化技术,进一步抑制探测器表面漏电,对于FPA尤其需要寻找更合适的钝化工艺。
3)发展HOT器件,实现高温探测。现有的InAs/GaSb T2SLs长波红外探测器均是制冷型器件,体积大使得移动受限,同时成本也高。已有报道实现了室温下(300 K)InAs/GaSb T2SLs短波红外探测器的应用,但实现高温(150 K)乃至室温下的长波探测,InAs/GaSb T2SLs红外探测器仍然面临很大的技术挑战。
4)拓宽成像谱域,实现多色探测。InAs/GaSb T2SLs红外探测器不仅在改进单色探测器性能方面逐步成熟,同时,在双色红外探测成像方面也取得一系列的进展。多色探测能同时得到不同波段的光谱信息,显著提高对目标物的识别与跟踪,且该技术还能够提供先进的彩色处理算法以进一步提高灵敏度,使其高于单色成像仪。InAs/GaSb T2SLs多色长波红外探测器的产业化具备广阔的前景,将成为新一代红外探测系统最有力的竞争者。
总结
InAs/GaSb T2SLs长波红外探测器的衬底材料有GaSb和InAs两种,本文系统报道了基于这两种衬底的器件结构设计的研究进展。器件结构从最初的PIN(PΠN)发展到现在的NBN(PBN)和PB₁IB₂N(PB₁ΠB₂N)结构,其吸收区材料从InAs/GaSb改善到InAs/InAs₁₋ₓSbₓ或InAs/GaAs₁₋ₓSbₓ,随着器件结构的优化探测器性能也得到大幅提升。综合考虑截止波长、暗电流和量子效率等相关因素,以InAs为衬底、吸收区材料为InAs/InAs₁₋ₓSbₓ、结构为PB₁IB₂N型的长波红外探测器体现出较好的器件性能。再结合ZnS和Ge多层膜的微结构设计或者重掺杂缓冲层,同时采用ICP干法刻蚀工艺,该器件的50%截止波长达到12 μm,量子效率提升到65%以上,暗电流密度降低到1×10⁻⁵A/cm²。与此同时,与Sb基能带工程相关的物理学将给InAs/GaSb T2SLs长波红外探测器结构带来新的性能提升,对应的FPA在可操作性、空间均匀、可扩展性等方面将表现越来越出色。
这项研究获得云南贵金属实验室科技计划项目(YPML-2022050220)的资助和支持。
论文链接:http://hwjs.nvir.cn/cn/article/id/31025f89-daee-4470-bfa6-4060252fd603

