二氧化钒(VO₂)材料是一种具有绝缘态到金属态可逆相变特性的材料,在光器件及信息技术中有非常广泛的应用。研究表明,相变前后材料结构的变化使得VO₂对红外光呈现出由透射向反射的可逆转变。VO₂材料在太赫兹(THz)频段也有类似的独特性能。随后,国内外研究者们开展了VO₂材料在THz频段的薄膜相变特性研究,主要包括热致相变、电致相变、光致相变等。VO₂薄膜在上述研究过程中表现出来的电学和光学性能,目前已成为THz频段超材料、功能性器件研究的热点,有望在THz开关、频率选择器和调制器等方面获得广泛应用。
对于VO₂材料,大多数情况都是研究其薄膜的特性。然而,当材料作为调制器等功能器件来使用时,包括衬底、过渡层和薄膜样品在内的整个材料的光谱特性的研究显得更为重要和直观。在THz频段,傅里叶变换光谱测量技术是研究1.5~20.0THz范围内材料光谱最常用的技术手段。与红外光频段的应用相似,THz频段物质的透过率、反射率、吸收率以及偏振特性等均可以采用上述傅里叶变换光谱技术来直接测量或间接获得。
据麦姆斯咨询报道,近期,中国科学院上海微系统与信息技术研究所太赫兹固态技术重点实验室研究团队在《太赫兹科学与电子信息学报》期刊上发表了以“二氧化钒材料相变的太赫兹光谱与阵列成像”为主题的文章。
该文章首先采用傅里叶变换光谱测量技术,测量分析了硅基VO₂材料在2.5~20.0THz频段的透射谱和反射谱。为了体现样品作为调制器的整体特性,测量了包含硅衬底、过渡层和VO₂薄膜在内的整个材料的光谱特性。同时,为了对比在4.3THz处的光谱测量结果,采用一套工作频率为4.3THz的阵列成像系统,测量分析了上述硅基VO₂材料相变前后的透过性差异。在透过率方面得出了与光谱测量结果相吻合的结论,最终获得了硅基VO₂材料整体作为调制器时最大最小透过率幅度的变化,从而为进一步开发3.0THz以上硅基VO₂调制器以及调制器性能的研究奠定了很好的基础;同时借助电驱动VO₂相变的手段,有望在THz高速调制技术方面获得重要应用。
VO₂薄膜参数
VO₂薄膜的制备方法有很多,主要包括分子束外延(MBE)、化学气相沉积(CVD)、脉冲激光沉积(PLD)以及磁控溅射法(MS)等,本文所用样品具体制备方法为溅射氧化耦合法(SOC),即首先将HRSi衬底氧化,在HRSi表面形成一层二氧化硅(SiO₂)薄层作为过渡层,然后采用直流磁控溅射技术在SiO₂表面沉积金属钒薄膜,最后在约740K的空气环境下对金属钒薄膜进行充分氧化,使之形成VO₂薄膜。其中HRSi衬底直径为15mm,电阻率>5000Ω·cm,HRSi/SiO₂/VO₂的厚度分别为500μm/20nm/1000nm。硅基VO₂样品的材料结构示意图如图1所示。
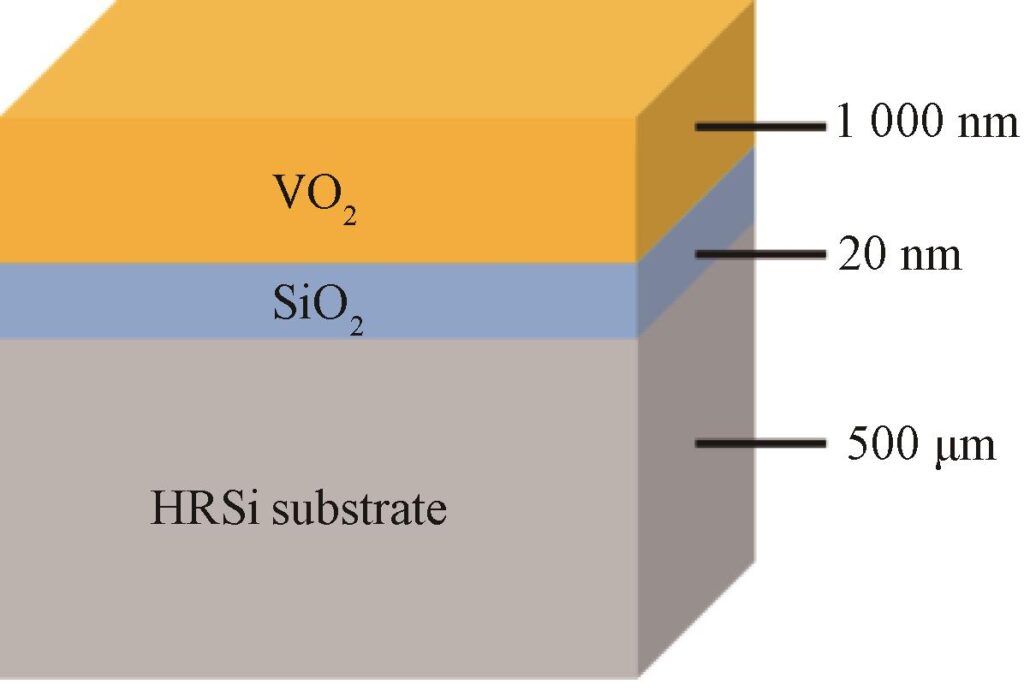
测量系统介绍
THz光谱测量系统
傅里叶变换光谱测量系统是THz频段非常传统的光谱测量手段,它是一种基于迈克尔逊干涉仪来实现光谱测量的仪器,这种仪器利用氦氖激光器的半波长(316.4nm)作为迈克尔逊干涉仪中动镜移动的基准长度,通过将宽谱辐射源形成的干涉信号进行离散化处理,获得辐射能量随动镜位置的变化曲线,最后采用傅里叶变换,将上述曲线通过特定的取值函数进行优化,得到能量随波数(频率)的变化和分布,即光谱曲线。在光谱测量过程中,为了同时获得VO₂样品上某一个点的透射和反射信息,采用与光谱仪(BRUKER VERTEX 80v)匹配的11°(入射角)透/反射样品架来实现,测量时入射光从有VO₂薄膜的一侧入射;样品温度的控制则采用一个变温杜瓦(OXFORD CF-V)来实现。光谱测量过程中样品腔(sample cavity)内部结构及光路示意图如图2所示,其中样品透射和反射谱信息的测量通过旋转反射镜(rotating mirror)来切换。光谱测量时,Globar光源的光阑孔径设置为3mm,光谱分辨力设置为2cm⁻¹;被测样品的变温范围为293~350K。
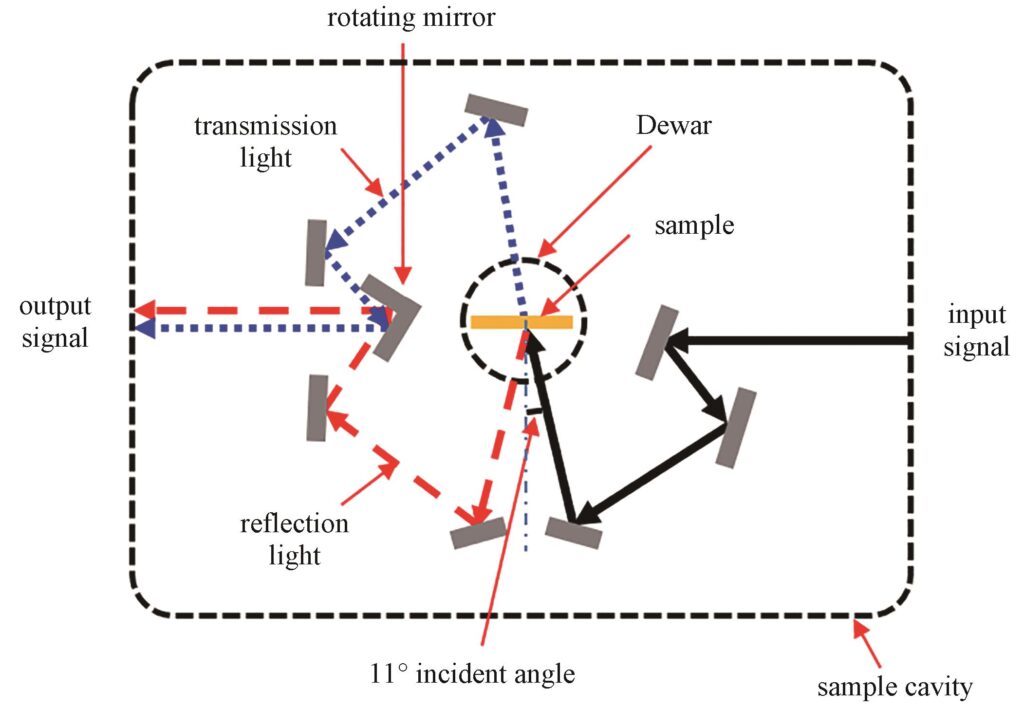
THz阵列成像系统
上述变温THz光谱测量系统揭示的是不同频率处样品相变过程呈现的透过率和反射率变化,为了揭示整个样品不同区域的相变过程,本文采用一套THz阵列成像系统对VO₂相变过程的透过性进行了测量,测量装置示意图如图3所示。成像系统所用的光源为THz量子级联激光器(QCL),其激射频率为4.3THz,THz QCL发出的激光在经过二维摆镜(2D wobbling mirror)匀束后,被一个THz频段的高密度聚乙烯(HDPE)透镜(lens)会聚成平行束,平行束经过样品载板后,到达带镜头的THz阵列探测器,经二维摆镜匀束后的成像光斑直径可达42mm,被成像样品放置于样品载片上进行THz频段的透射成像,上述阵列成像系统的单帧成像时间约0.23s,对应成像帧率8.5Hz,阵列的单像元尺寸为23.5μm,像素为320×240。
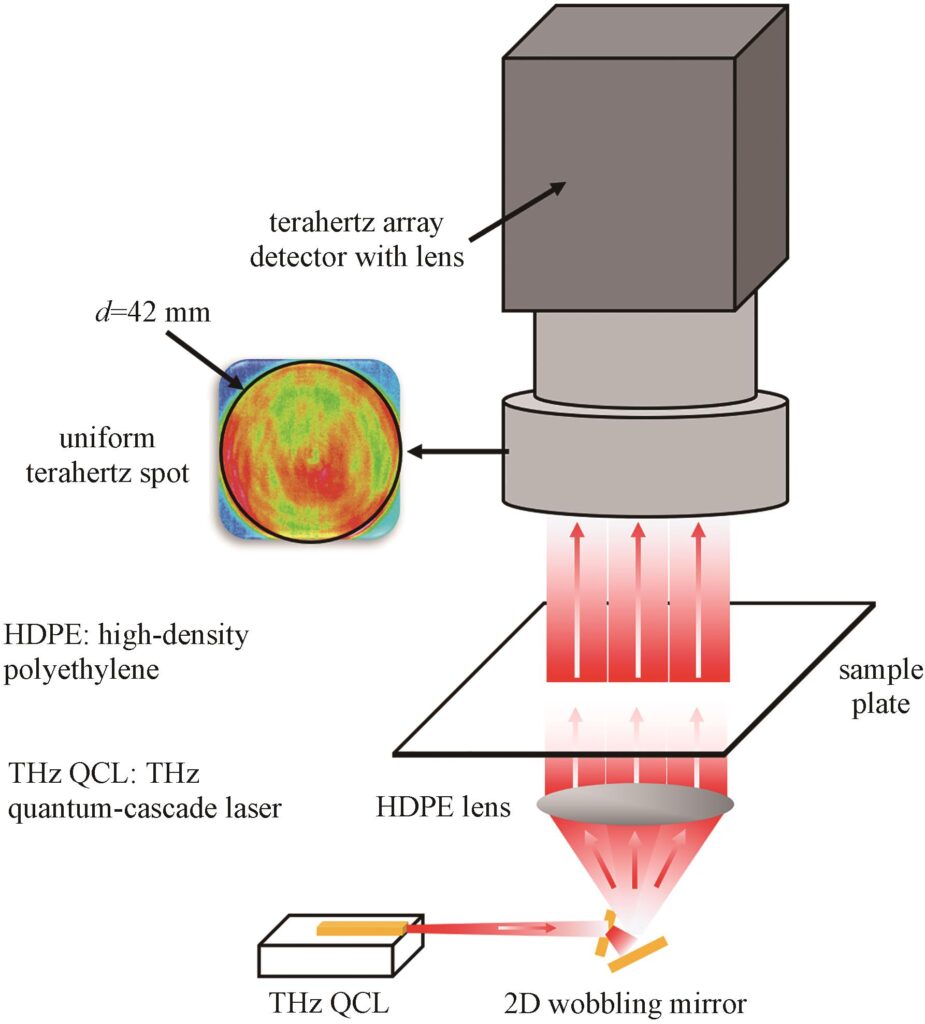
太赫兹光谱测量与阵列成像结果
光谱测量结果
为了直接获得样品本身作为相变应用材料的整体性能,采用图2所示的可变温透/反射光谱测量附件,测量得到了293~350K温度范围内整个硅基VO₂材料在2.5~20.0THz频段的透射谱和反射谱,测量结果如图4所示。光谱测量结果表明,硅基VO₂材料对THz辐射既具有透射调制功能,也具有反射调制功能。值得注意的是,同一温度下,材料在2.5~20.0THz范围内的反射率变化率差异不大,说明硅基VO₂材料在制备超宽谱THz反射调制器方面具有很好的优势。此外,由于一定厚度的蓝宝石衬底在THz频段的透过率较低,而掺杂硅衬底在THz频段存在很强的自由载流子吸收,也进一步说明了上述基于高阻硅衬底生长的VO₂在THz频段作为调制器材料的应用潜力和优势。
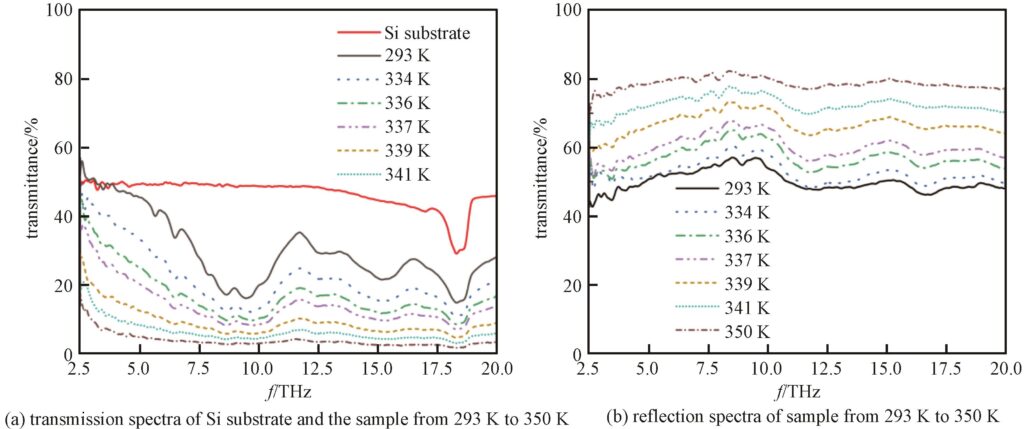
为了获得某一频率处硅基VO₂材料的透过率、反射率和吸收率随相变温度的变化,从图4的光谱中将4.3THz处的随温度变化的光谱信息提取出来,结果如图5所示。硅基VO₂薄膜材料透过率和反射率快速变化的温度范围为334~341K(68℃),对应温差为7K,相变前后样品对4.3THz辐射的透过率变化达40%以上,反射率变化接近30%。

阵列成像结果
为了获得上述硅基VO₂材料不同区域的相变情况,采用一套4.3THz的阵列成像系统获取了该样品材料由金属态变为绝缘态的THz图像。由于成像系统中竖直成像光路的设置,样品加热过程无法直接在光路中进行,为此先将成像系统调试至最佳状态,然后用外部加热台将样品充分加热至金属态,之后迅速将样品放入成像区域进行成像和数据获取,同时观察阵列成像系统中样品的图像变化。当样品的THz图像基本无太大变化时,即样品转变成绝缘态时,再次进行样品成像和数据获取。上述测量结果如图6所示,其中图6(a)为金属态下的THz图像,图6(b)为绝缘态下的THz图像。为从THz图像信号中估算样品的透过率,取图6(a)和图6(b)中从顶部开始的第192行数据,分别将金属态和绝缘态样品对应的THz图像信号幅值绘制成按水平方向像素分布的曲线,如图6(c)所示。

上述THz阵列成像过程获得了整个硅基VO₂材料相变时的透过率变化和相变时间,计算得到样品在金属态和绝缘态下的透过率与傅里叶变换光谱测量得到的结果相近。进一步验证了硅基VO₂材料作为THz频段透射调制器的可行性。不过,由于上述阵列成像系统中THz阵列探测器的成像速度并不是很快,且在图像获取过程中并没有充分发挥THz阵列探测器的时间分辨优势,因此,未来可采用成像速度更快的高速THz成像系统揭示VO₂材料的快速相变过程。
结论
本文采用变温傅里叶变换光谱测量技术,测量分析了一种磁控溅射氧化耦合法生长的硅基VO₂材料在相变过程的光谱特性,获得了整个样品在2.5~20.0THz频段透射谱和反射谱随温度的变化。研究结果表明,当温度从293K升至350K时,硅基VO₂材料从绝缘态转变成金属态,对应材料在4.3THz处的透过率由47.4%降至5.8%,透过率变化超过40%,反射率则从48.5%升至78%,反射率变化近30%。为了进一步获得硅基VO₂材料在相变过程中各区域的透射特性,采用一套4.3THz的阵列成像系统,测量了该样品整个区域在相变前后的THz图像及相应的透射信号,获得了该材料由金属态转变为绝缘态时,其对4.3THz激光信号的透过率由6.7%升至50.7%,透过率变化为44%,与傅里叶变换光谱测量结果相当。上述研究结果为硅基VO₂材料用于2.5THz以上电磁辐射的透射调制和反射调制提供了很好的实验数据支撑,在结合光致相变和电驱动相变等调制手段后,有望在2.5THz以上频段的快速调制技术中获得应用。
这项研究获得国家重点研发计划资助项目(2017YFA0701005)、国家自然科学基金资助项目(61927813;U2241227;62035014)和上海市自然科学基金资助项目(17ZR1448300)的支持。
论文信息:
DOI: 10.11805/TKYDA2022098
推荐培训:
《第49期“见微知著”培训课程:光谱仪及光谱成像》

