位错密度是影响碲镉汞材料及器件性能的重要参数,大量实验表明:贯穿PN结的位错作为器件漏电通道,可导致暗电流增大,降低器件的信噪比。此外,吸收区的位错会作为复合中心,通过SRH复合显著降低材料的载流子寿命,降低器件的品质因子R₀A,最终影响器件的响应率和探测率。碲镉汞中材料的位错密度已经成为制约红外焦平面长波器件性能的瓶颈。因此,研究HgCdTe材料位错缺陷特性,寻找能够有效降低位错密度的热处理工艺对于提高材料的质量和器件的性能具有重大意义。
据麦姆斯咨询报道,近期,华北光电技术研究所的科研团队在《激光与红外》期刊上发表了以“退火工艺对HgCdTe材料位错密度及电学性能影响的研究”为主题的文章。
本文分别采用高低温退火和循环变温退火的方式对HgCdTe材料进行热处理,研究不同退火条件对碲镉汞材料位错密度及电学性能的影响。
实验方案
碲镉汞材料的热处理及位错腐蚀方法
实验采用基于液相外延技术制备的长波HgCdTe材料(编号分别为S1、S2)。首先将碲镉汞材料分为三份,如图1所示。

随后选取边缘的两份材料进行不同条件的热处理,其中一份进行高低温饱和汞压闭管退火,即在高温环境下恒温热处理3 h,随后降温至低温状态,并恒温72 h。选取另一份碲镉汞材料进行循环变温退火处理(热处理时样品首先快速升温到高温状态,并恒温3 h,随后降温到低温状态并恒温24 h,然后继续升温到高温状态,随后这一过程被循环3次并结束热处理)。中间的一份原生碲镉汞材料作为对比试验片不做任何处理。
采用化学腐蚀法对HgCdTe材料的位错密度进行统计分析,本实验所有样品选用Chen式腐蚀剂(V(H₂O):V(HCl):V(HNO₃):m(K₂Cr₂O₇)=80 ml:10 ml:10 ml:10 ml:8 g)对碲镉汞材料进行位错腐蚀。
测试及分析方法
实验选用微分霍尔测试测试系统表征HgCdTe材料的电学性能,包括导电类型、载流子浓度和迁移率。选用OLYMPUS公司生产的OLS5000型共聚焦显微镜(1000倍下)对位错腐蚀后的样品表面进行观察计数,选取样品边缘四角及中心共五个区域(每个区域3个点)对位错腐蚀坑密度(EPD)进行算数平均统计,最后得到样品的位错密度。
结果与讨论
不同退火工艺对HgCdTe材料位错密度的影响
位错是HgCdTe材料中一种最为常见的线缺陷,其密度大小是衡量晶体质量的重要参数。编号为S1、S2的薄膜在不退火、高低温退火和循环退火后材料经位错腐蚀后的位错密度统计情况如图2所示。

从图中可以看出高低温退火片的位错密度相较于原生片的位错密度有一定的降低,循环变温退火的位错密度相较于高低温退火的位错密度又有进一步降低,该结果与前人所报道的一致。在研究不同退火工艺对位错密度影响的机理前,需要对位错的产生和演化原理进行简单介绍。
当碲镉汞材料在碲锌镉衬底上外延时,由于外延层与衬底层间存在一定的晶格失配,外延层进行双轴应变状态下的生长,应变在外延过程中不断积累应变能。随着外延厚度的增加,应变能不断积累增大,最终导致外延层中产生应变弛豫———即当外延厚度超过临界厚度hc时,外延层中储存的应变能达到极限需以释放,引起晶面的滑移,从而使晶面两侧原子的排列发生位移。弛豫过程中出现的原子偏离正常周期的排列即为位错。在外延层界面附近产生位错是弹性应变弛豫的最主要方式。
碲镉汞材料中位错的产生机理,如图3所示。图3(a)所示为衬底材料中由于本征应力所产生的位错,位错将会随着外延生长的进行进入外延层,当外延层的厚度超高hc时薄膜开始弛豫释放应变能,晶面发生偏移,随后位错在整个外延层上进行贯穿。图3(b)所示为晶格失配界面处由于应变而自然产生的位错,失配位错的两端贯穿至外延层表面。
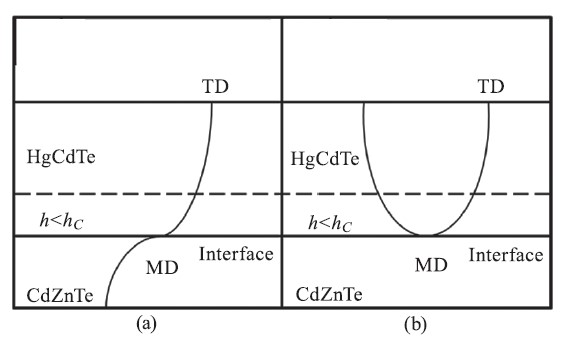
本实验中高低温退火片的位错密度相较于原生片的位错密度有一定的降低。这是由于退火在材料中引入的热应力,破坏了系统原有的平衡状态,使得穿越位错能够克服能量势垒而运动,在运动的过程中,部分相邻的位错线之间相互吸引、纠缠,使得位错线之间交和、湮灭,最终降低材料的位错密度,原理示意图如图4所示。

实验中循环变温退火的位错密度相较于高低温退火的位错密度又有进一步降低。这是由于循环变温退火过程中因温度快速变化所在材料中引入热应力的次数增加,从而对穿越位错的驱动效果更为显著,位错在运动的过程中不断合并、消除,进一步降低了材料的位错密度。相较于高低温退火工艺,循环变温退火的位错密度分别下降了20.8%、46.3%,因此循环变温退火工艺是一种较为有效降低HgCdTe位错密度的方法。
不同退火工艺对HgCdTe材料电学性能的影响
表1为HgCdTe薄膜在高低温退火、循环变温退火以及在原生状态下的Hall测试结果。一般情况下,由于在外延中的失汞过程,液相外延制备的原生HgCdTe材料的导电类型为p型,但本实验通过Hall测试显示HgCdTe原生片的导电类型为“n型”,结果与经验相悖。有文献报道,这种性能差、迁移率低的n型材料,实际上是性能优良的“弱p型”材料。这是由于在77 K下Hall测试时,p型碲镉汞材料的空穴迁移率相较于电子迁移率小两个数量级,因此采用传统的固定磁场霍尔测试不能有效区分“弱p型”材料和低迁移率的n型材料。表1 不同热处理条件下碲镉汞的载流子浓度和迁移
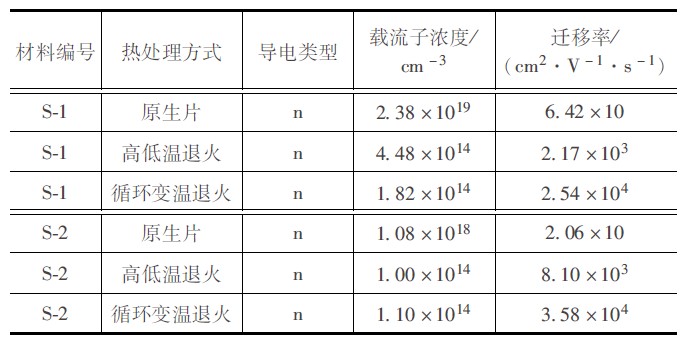
从1表中可以看出,热处理后的HgCdTe材料的载流子浓度相较于原生片的载流子浓度明显降低,迁移率显著增加。这是因为HgCdTe材料在热处理过程中,处于饱和汞压的氛围下,HgCdTe材料与环境中的Hg原子进行交换,环境中的Hg原子更充分地填充到HgCdTe材料内部的Hg空位上,导致材料的载流子的浓度降低,迁移率提升。
值得注意的是相较于高低温退火,循环变温退火后HgCdTe材料的迁移率有了数量级的提高。载流子的迁移率反映了载流子在电场下的输运能力,载流子在输运过程中所受到的散射强度将直接影响载流子的迁移率。有研究基于量子散射理论建立了包含位错散射机制的载流子模型,对HgCdTe材料载流子的散射行为进行仿真,发现在低掺杂(<10¹⁶cm⁻³)、高位错密度的材料中,位错散射机制将超过电离杂质散射机制成为主导散射机制从而使载流子迁移率迅速降低,位错散射对HgCdTe材料的迁移率起着重要作用。因此,循环变温退火使得HgCdTe材料位错密度降低,进而降低位错散射作用,可能是最终导致材料迁移率迅速增加的原因。
结论
本文对不同热处理退火工艺对HgCdTe材料的电学性能及位错密度的影响进行研究。结果表明,经循环变温退火后碲镉汞材料的位错密度有了显著的降低,并且在该条件下仍然可以得到较为理想的电学性能。研究发现循环变温退火工艺一种较好提升HgCdTe材料性能的热处理方法。论文链接:
DOI: :10.3969/j.issn.1001-5078.2023.04.012

