分子束外延碲镉汞技术是制备第三代红外焦平面探测器的重要手段,基于异质衬底的碲镉汞材料具有尺寸大、成本低、与常规半导体设备兼容等优点,是目前低成本高性能红外探测器发展中的研究重点。
碲镉汞(MCT)在整个红外谱段带隙可调,具有高量子效率以及低暗电流等优点,是目前军事领域应用最广泛的红外探测材料。相较于其他薄膜外延技术,分子束外延技术(MBE)具备能带调控、原位监控、异质外延等诸多优点,可实现复杂结构材料的制备。通过Zn组分的调整,碲锌镉(CZT)衬底可做到与碲镉汞材料完全晶格匹配,在碲锌镉衬底上获得的碲镉汞材料晶体质量较高,其位错腐蚀坑密度(EPD)一般在1×104~1×105 cm-2范围内。
分子束外延碲镉汞通常选用(211)面碲锌镉,碲锌镉衬底成品率更低、衬底尺寸更小、价格更加昂贵,高温器件、中长双色器件等高端探测器中仅碲锌镉衬底价格就能占到组件价格的20%到40%。相较于碲锌镉衬底,异质衬底(如Si、GaAs、Ge、GaSb 等)具有尺寸大、成本低、与常规半导体设备兼容性好等优点,在异质衬底上外延碲镉汞材料是国内外主流红外机构在低成本高性能红外探测器方向发展的研究重点。
据麦姆斯咨询报道,近期,昆明物理研究所杨晋等人在《红外技术》期刊上发表了以“异质衬底外延碲镉汞薄膜位错抑制技术进展”为主题的综述文章。杨晋主要从事红外光电材料的研究工作。
这项研究对碲镉汞薄膜位错密度随薄膜厚度的变化规律进行了计算,分析了决定原生碲镉汞薄膜位错密度的主要因素,明确了引入位错抑制技术的必要性。基于此,总结了循环退火、位错阻挡和台面位错吸除3种位错抑制技术的原理及研究进展,讨论了3种技术后续的发展趋势及研究重点。
异质衬底外延碲镉汞位错密度随膜厚的演化规律
在异质外延体系中,ρ~1/h和ρ~1/h2是两种经典的位错密度随厚度演化模型。ρ~1/h模型认为位错随薄膜厚度增加而延伸,与延伸过程中相遇的位错发生湮灭反应(反应后两条位错均消失)。ρ~1/h2模型假设位错反应半径ra’随薄膜厚度增加而线性增加,与相遇的位错发生湮灭反应。
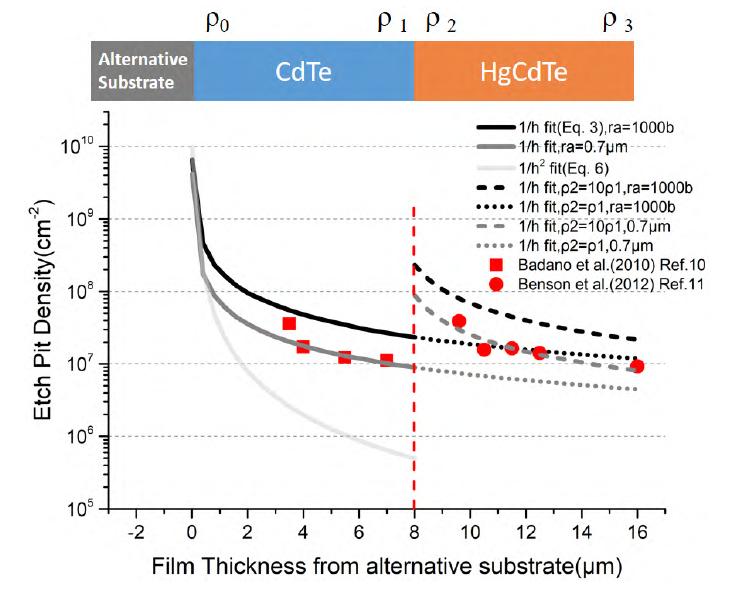
异质衬底与碲镉汞间通常需要制备一个碲化镉缓冲层,常规外延膜层结构如图1上部所示,ρ0、ρ1、ρ2以及ρ3分别表示衬底与碲化镉界面、碲化镉表面、碲化镉与碲镉汞界面以及碲镉汞表面4个位置处的贯穿位错密度。位错反应半径和薄膜厚度是决定原生碲镉汞材料贯穿位错密度的主要参数。由于位错反应半径的限制,原生碲镉汞材料(8μm膜厚)贯穿位错密度无法降低至8×106 cm-2以下,与长波器件对于碲镉汞位错密度的要求存在较大差距。为了进一步降低材料贯穿位错密度,位错抑制技术的引入是必须的。
异质衬底外延碲镉汞薄膜位错抑制技术进展
循环退火(TCA)技术是出现最早、研究最为广泛的位错抑制技术。它不同于传统单周期长时间退火,而是通过短时间多周期循环对原生碲镉汞材料进行原位或离位热处理,利用高温在外延层与衬底之间引入的热失配应变,多次驱动位错进行运动,使位错相遇并发生反应,达到降低位错密度目的。
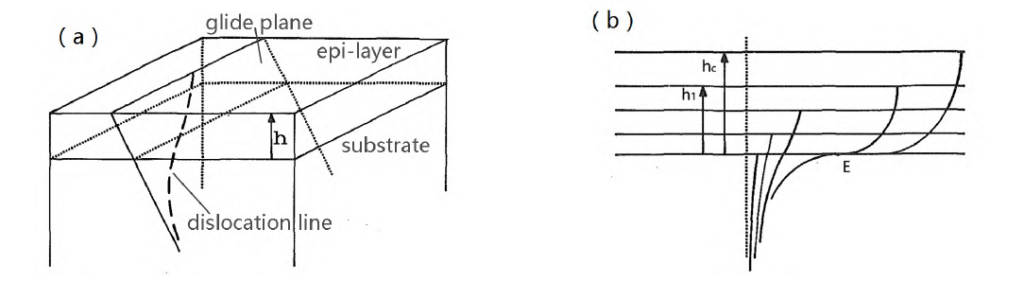
外延过程中,贯穿位错在界面处将发生偏转,偏转程度与失配度及外延层厚度有关。当外延层厚度超过一定厚度h1时(h1<临界厚度hc),如图2所示,位错达到最大偏转程度,此时位错将沿界面进行延伸,延伸长度可达厘米量级。当薄膜厚度进一步增加超过临界厚度hc后,位错又将转向并穿入到外延层中。位错阻挡技术利用了上述位错在界面处偏转并延伸的特性,人为制造具有一定失配度、厚度及层数的交替阻挡层,使位错被阻挡且沿阻挡层界面延伸,延伸过程中增加了位错间发生反应的概率,最终达到降低位错密度的效果。位错阻挡技术在Ⅲ-Ⅴ族和Ⅱ-Ⅵ族材料异质外延中均展现出了较好的位错抑制效果,但后续获得突破的技术难度较大。
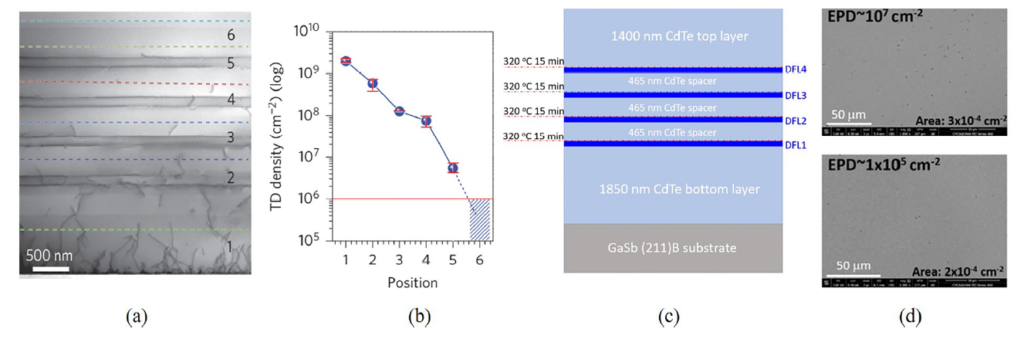
台面位错吸除的思想来源于选区外延,由P.Müller等人最先提出,它是将外延材料进行台面成型,再进行退火处理,使台面上的贯穿位错移动并消失于台面侧壁的技术。台面隔离沟槽深度、沟槽侧壁角度等将影响位错去除效率及后续芯片工艺难度,需要对台面位错吸除与芯片加工进行工艺融合。由于镜像力可看作真空对位错的吸引力,隔离台面的沟槽越深,碲镉汞薄膜中贯穿位错受到镜像力作用的部分越多,因此通常需要刻蚀开槽到碲化镉与碲镉汞界面附近,即沟槽深度与碲镉汞薄膜厚度相当。另外,沟槽侧壁角度虽然与位错去除效率关系不大,但与器件占空比、侧壁钝化难度等直接相关。
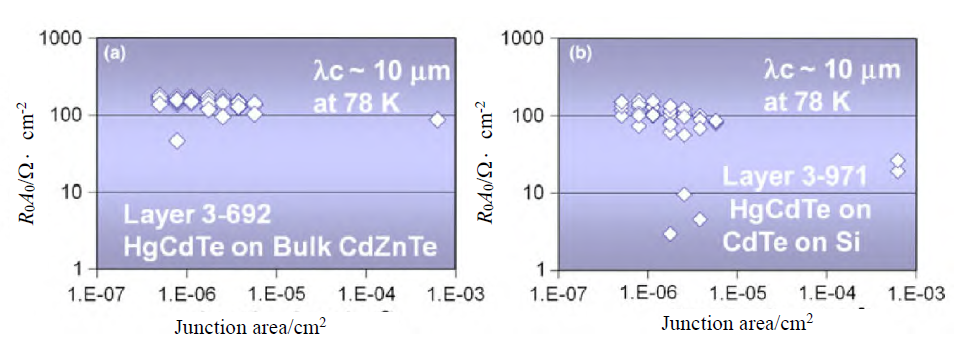
结语
ρ~1/h模型可以准确地描述异质衬底上原生碲化镉、碲镉汞薄膜位错密度随厚度的变化规律,由于位错反应半径的限制,原生碲镉汞材料贯穿位错密度难以降低至5×106cm-2以下,与长波、甚长波器件对材料位错密度的要求存在较大差距,因此有必要引入位错抑制技术。
循环退火技术近年来得到了广泛研究,由于位错反应过程中钉扎位错的产生,碲镉汞薄膜位错密度容易在1×106cm-2附近将出现饱和。模型计算结果显示碲镉汞位错密度的进一步降低需要合适的退火温度和更多的循环次数,但多次循环退火工艺将引入表面劣化、材料中原子互扩散等问题。因此循环退火技术更适用于短波、中波器件探测性能提升,但对于长波及甚长波器件,其后续发展潜力不大。位错阻挡技术方面,目前异质衬底上碲化镉位错密度已降至1×105cm-2附近,后续的难点是在高质量碲化镉上制备出位错密度相当甚至更低的碲镉汞薄膜。在碲化镉和碲镉汞间的HgCdTe/CdTe位错阻挡层或组分渐变过渡层是可能的解决途径,但总体来看获得技术突破的难度较大。台面位错吸除技术目前针对HgCdTe/Si薄膜获得了较好的位错抑制效果,可以将材料位错密度控制在5×105 cm-2以内,显示出了巨大的发展潜力和价值,后续将台面退火工艺与芯片工艺融合后,有望大幅促进低成本长波、中长波、甚长波器件的发展。
该研究获得核高基重大专项项目的支持。
论文链接:
DOI:10.11846/j.issn.1001-8891.2022.8.hwjs202208010

