工作在通讯波段1310 nm和1550 nm波段的短波红外单光子探测器(SPAD),在光纤通讯、激光雷达、量子保密通讯等技术领域具有广泛的应用需求。随着InP/InGaAs短波红外单光子探测器(SPAD)在材料结构、材料质量、工艺制备和淬灭电路等方面的不断改进和发展,目前InP/InGaAs SPAD的性能获得了显著的提升,探测效率典型值从20%提升到30%,而暗计数率进一步降低,低于kHz。另外一个显著的性能提升是用以抑制器件后脉冲的死时间降低,通过优化淬灭电路、采用负反馈单光子探测器等方法,目前报道的死时间已经从μs量级提升到亚μs。这对于高速应用提供了重要的芯片技术支撑。
对于1550 nm的单光子探测技术,除了传统的InP/InGaAs SPAD,目前还发展了Sb基数字合金构建的低噪声材料体系、采用离化工程的多倍增InP/InGaAs SPAD、InAlAs/InGaAs SPAD等新材料、新结构探测技术,使短波红外单光子探测芯片技术获得了快速的发展和进步。
据麦姆斯咨询报道,近期,云南大学与云南贵金属实验室有限公司的联合科研团队在《红外与激光工程》期刊上发表了以“短波红外单光子探测器的发展(特邀)”为主题的综述文章。该文章第一作者和通讯作者为史衍丽研究员,主要从事半导体光电器件物理与器件方面的研究。
文中对近10年来基于InP/InGaAs SPAD的技术改进进行了归纳总结,分析了器件设计和研制中面临的主要问题、技术解决途径和取得的进展,重点介绍了国内外高温、高速InP/InGaAs单光子探测器及焦平面阵列的发展,对探测效率、暗计数率、后脉冲和时间抖动等性能进行了对比分析;最后结合出现的离化工程、新机理新材料体系,探讨了短波红外单光子探测器未来的发展趋势。
InP/InGaAs雪崩二极管探测器设计和研制面临的问题
InP和In0.53Ga0.47As材料晶格匹配,但具有不同的带隙值,室温下两者的禁带宽度分别约为1.35 eV和0.75 eV,因此,采用这两个材料作为倍增层和吸收层,一方面对应着截止波长1.65 μm的吸收,另外一方面宽带隙InP倍增层可大大降低高电场下的隧穿电流。因此,分离吸收、渐变、电荷、倍增(SAGCM)结构一旦被发明和应用以来,一直沿用至今,如图1(a)所示,入射光在InGaAs吸收区中被吸收形成电子空穴对,在电场作用下光生电子空穴对被分开,空穴经过渐变层及电荷层漂移到InP倍增区。在倍增层中空穴与晶格碰撞产生新的电子空穴对,新的电子空穴对在电场中加速与晶格碰撞产生新的电子空穴对,该过程重复发生,载流子触发自持雪崩,使微弱的光信号转化为足以探测的电信号。结构中渐变层消除了InGaAs-InP异质界面处的空穴堆积;薄且高掺杂的电荷层调控了吸收区和倍增区的电场,使SPAD在工作时吸收区电场足够低以避免载流子遂穿,同时倍增区的电场足够高以确保载流子在倍增区能触发雪崩倍增,通过保护环降低边缘击穿。
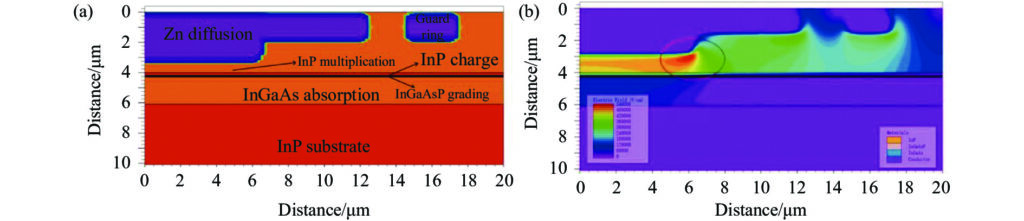
InP/InGaAs SPAD设计的重点在于精确控制吸收区、倍增区的电场大小。根据InP、InGaAs材料的禁带宽度,为了避免发生带间隧穿,要求在两种材料内的电场不能高于7×10⁵ V/cm,1.5×10⁵ V/cm,而为了维持载流子在倍增区的雪崩和在吸收区的漂移,两种材料内最低的电场需要大于4.5×10⁵ V/cm,1.0×10⁵ V/cm。为此需要优化设计电荷层、倍增层等材料参数,同时要求材料生长时能精确控制各层的掺杂浓度和厚度。
倍增区内的电场分布不均匀,尤其边缘尖峰电场会引入过早的边缘击穿,使器件无法正常雪崩,器件性能大大衰退。因此实际器件制备时通常要采用二次扩散和增加保护环来抑制边缘击穿,但器件内部仍存在不均匀电场,如图1(b)所示,图中给出了器件处于击穿电压下的电场的二维分布,其中的红圈位置是由于二次扩散时形成的尖角产生的不均匀区域,该区域内电场高于中心倍增区内的电场,导致过早的边缘击穿和大的暗计数。因此实现均匀的雪崩电场也是InP/InGaAs SPAD设计和制备的一个重点。
针对以上两个关键问题,为了精确控制电场大小,并获得均匀的倍增区电场分布,目前主要采用以下几种方法:(1)使用以二甲基锌作为锌源的金属有机化学气相沉积(MOCVD)设备进行锌扩散,通过调整扩散参数包括Zn扩散温度、磷化氢超压和二甲基锌源流速等,优化电场分布和倍增区的缺陷分布。(2)采用两步同心扩散方法控制二极管中心区域的p-n结比外部区域更深。(3)在器件的中心处选择性生长未掺杂的锥形InP层,获得中心区薄、而边缘逐渐增厚的InP层,通过这一锥形InP层扩散锌,使InP中心区的掺杂比外围区更深,从而确保器件中心区电场高于边缘周围的电场。(4)增加电荷层浓度,在InGaAs吸收区中实现较低的电场,以减少来自吸收层场增强产生的暗计数率。
目前InP/InGaAs SPAD还存在着的一个问题是后脉冲现象,这也是当前制约InP/InGaAs在高速应用中的一个瓶颈问题。这主要是由于InP倍增层里存在深能级缺陷,对倍增层里产生的大量雪崩载流子进行俘获,并慢慢释放导致虚假雪崩计数信号,后脉冲会增加暗计数,产生误计数。为了降低后脉冲概率,目前采用的主要方法有:(1)对InP材料生长技术和SPAD芯片工艺的持续改进;(2)适度降低雪崩载流子数,但这同时降低了探测效率;(3)通过增加两次雪崩之间的时间(又称之为死时间),使陷阱俘获的载流子获得充分的释放,从而降低后脉冲概率,但这大大降低了最大计数率。(4)通过采用正弦门控的淬灭方式,减少雪崩时的门宽时间,降低雪崩量,从而减小后脉冲。
InP/InGaAs单光子探测器性能改进
通过对器件结构参数的优化设计,在器件光入射窗口涂上抗反射涂层或增加微透镜,优化器件制备工艺条件使有源区电场更均匀,大大改善了InP/InGaAs SPAD的探测效率、降低了暗计数率,近10年国内外有代表性的进展如表1所示。
表1 近10年报道的高探测效率InP/InGaAs SPAD的性能汇总

探测效率是光电探测器的重要指标,表征了器件的光电探测能力。该效率是几个效率的乘积,包括量子效率、空穴被注入到倍增区的概率、空穴在倍增层触发雪崩的概率、雪崩被探测到的概率,因此,提高器件的量子效率可提高探测效率。
暗计数率也是器件的一个重要性能指标,器件在工作时,希望探测效率高的同时暗计数尽可能低。暗计数率是器件在没有光照条件下,单位时间内器件内部触发雪崩的次数,是一个统计平均值,表征SPAD的基本噪声。暗计数主要来源于In0.53Ga0.47As窄带隙吸收区材料热激发及InP倍增层里的遂穿,为了减少由热激发带来的暗计数,将SPAD降温是一种有效的方法。暗计数的另一主要来源是倍增层里的隧穿,这主要是器件内部有源区高电场造成的,电场的不均匀、局部电场高也会引起场致隧穿或缺陷辅助隧穿,所以选择最佳的工艺条件使有源区电场更均匀,减少材料缺陷也是降低暗计数可行的方法。
高温工作的InP/InGaAs单光子探测器
InP/InGaAs SPAD需要在低温(约230 K)下工作,以降低暗计数率,但在低温时SPAD后脉冲大。若器件在室温条件下能保持可接受的暗计数率和探测效率,对抑制后脉冲、提高计数率具有显著的优势。工作温度为室温或接近室温(如零度以上,通过一级TEC很容易实现)被视为高温工作条件,有别于常规制冷单光子探测器,高温工作的单光子探测器需要对暗计数进行特别的抑制,一方面,这需要在材料结构、器件结构上进行特殊的设计,确保吸收区、倍增区与热有关的载流子激发、隧穿降至最小,由此引发的暗计数最小,暗计数率控制在可接受的范围内;另外一方面,通过运用正弦门控淬灭电路亚ns级的有效门宽,减少暗计数,也能使性能较好的单光子探测器在室温下工作。目前报道的高温器件性能如表2所示。
表2 国内外报道的室温SPAD性能

门控模式下采用正弦门,SPAD电容响应频率分布相对简单,主要集中在门的重复频率及其谐波频率上,采用低通滤波器很方便滤除噪声提取雪崩信号。
高计数率InP/InGaAs单光子探测器
InP/InGaAs SPAD向高计数率发展面临的一个关键问题是死时间不断变短带来的后脉冲概率增大。通过采用正弦门、自差分等技术目前实现了GHz的高速SPAD,相关的性能指标如表3所示。
表3 近10年报道的高计数率InP/InGaAs SPAD的性能汇总

正弦门控实现高计数率
日本大学的Naoto Namekata等人在2006年最早报道将800 MHz高频正弦门控技术应用到InP/InGaAs SPAD中用作门控淬灭,从而开始了将高速门控InP/InGaAs SPAD最大计数率引领到GHz的水平。利用高频正弦门控亚纳秒量级门宽、超窄死时间,以及通过SPAD后输出信号纯净的频谱成分这三大特点,Naoto Namekata等人在输出端口利用带阻滤波器滤去正弦门控信号及其高次谐波,成功从约0.1 mV的背景噪声中提取到了振幅约1 mV的微弱雪崩信号。通过不断优化系统,他们在2009年报道了正弦门控技术实现门控频率达到2 GHz的InP/InGaAs SPAD,并于2011年演示了超过100 km的量子密钥分发。在2020年,报道了过偏压超过12 V的高探测效率的正弦门控InP/InGaAs SPAD。在1.27 GHz门控频率下,55.9%探测效率时,后脉冲概率仅为4.8%,暗计数率为2350 kHz (归一化)。利用正弦门控技术,日内瓦大学于2010年实现了迄今为止速度最快的InP/InGaAs SPAD,2.23 GHz的门控频率,已经逼近InP/InGaAs SPAD的理论带宽极限。
2020年,中国科学技术大学在温度为300 K时,使用门高峰峰值为20.4 V,频率为1.25 GHz正弦门控,获得了探测效率为60%,暗计数率为744 kHz,和后脉冲概率为14.8%的结果。
自差分技术实现高计数率
2007年,东芝欧洲研究有限公司使用他们提出的自差分技术实现1.25 GHz方波门控(方波幅值4.6 V)下的高速InP/InGaAs SPAD,自差分电路如图2所示。该技术原理是首先将SPAD阳极输出的信号用功率分配器分割为两路,其中一路输出信号被延时一个周期,接着再直接将这两路输出信号进行差分,消除SPAD容性响应及电路寄生电容电感响应,雪崩信号即很容易地被提取。该技术的优点是可以采用多种延时手段、自差分原理可以适应任意SPAD输出信号的波形,但雪崩互相抵消的缺点导致自差分技术的最大理想计数率仅为门频率的一半。

基于2007年报道的自差分电路技术,2015年东芝研究欧洲有限公司优化了自差分模式,在该模式下使用频率为1 GHz,门宽为360 ps的门控信号,1550 nm的激光,温度为293 K,InP/InGaAs SPAD探测效率与后脉冲概率关系如图3所示。当探测效率为50%时,死时间为零时后脉冲概率为7%;当InP/InGaAs APD的探测效率为55%时,采集死时间为10 ns测量的后脉冲概率仅为10.2%。

InP/InGaAs单光子探测器焦平面阵列
焦平面阵列具有广泛应用,特别是人眼安全的1550 nm的InP/InGaAs SPAD阵列,可用于三维成像、激光雷达等。像素之间的串扰问题是制约高密度阵列性能的主要问题。另外,焦平面阵列的均匀性是保证焦平面工作的重要参数,阵列中像素的击穿电压越接近,其工作电压越接近,阵列工作条件实现越容易。阵列均匀性包括击穿电压均匀性、暗电流均匀性、探测效率均匀性、暗计数均匀性,通常通过阵列元素的击穿电压分布、暗电流分布、暗计数分布、探测效率分布进行表征,目前国内外均有研究团队对焦平面阵列性能进行了报道,相关性能比较见表4。
表4 近10年SPAD焦平面阵列性能汇总

未来的发展趋势
通过在器件倍增层增加离化工程,采用噪声因子更小、带隙更宽且与吸收层InGaAs晶格匹配的In0.52Al0.48As作为倍增层、或采用数字合金新材料等方法以进一步提高短波红外单光子探测器的性能。
离化工程
对于SAGCM结构的短波红外单光子探测器,载流子离化倍增时,存在死区效应而需要厚倍增层,这降低了器件的响应速度。因此,2006年,康塞普西翁大学报告了具有能量积累层的分离吸收倍增层结构SPAD,该SPAD倍增层由宽带隙In0.52Al0.48As层(能量积累层)和InP层构成。由于能量积累层In0.52Al0.48As的离化能比InP的离化能高,InGaAs层中的光生空穴进入能量积累层后在电场的作用下积累能量,设计InAlAs层的宽度略小于空穴死区,空穴在InAlAs层中碰撞电离的概率为零,但空穴进入InP层时,其能量超过在InP中的电离阈值能量,因此,空穴进入InP倍增区将不需要空穴死区立即电离,这样既保证了器件的探测效率,同时降低了器件的过剩噪声因子。
2018年,美国海军实验室报道了基于碰撞电离工程制成的InAlAs/InGaAs雪崩光电二极管阵列,该阵列的几何结构如图4所示,阵列包括一个中心像素和四个同心外围像素。阵列直径为为264 μm,中心元直径为112 μm,相邻元素之间的距离约为10 µm。阵列填充因子约为85%,对于1550 nm波长的光、超过80 GHz的增益带宽积下测得的器件量子效率约为84%。

电子倍增InGaAs/InAlAs SPAD
倍增层材料除了空穴倍增的InP材料外,可以用与InGaAs晶格匹配、电子倍增的In0.52Al0.48As作为倍增材料。相比于InP,In0.52Al0.48As带隙更宽,雪崩击穿电压的温度依赖性相对InP更不敏感,因此InAlAs材料的SPAD工作温度具有灵活性。与InP/InGaAs SPAD相比,InGaAs/InAlAs SPAD具有高增益带宽积、低过量噪声、低温度系数和高灵敏度等优点。
2016年,谢菲尔德大学设计了用于探测1550 nm的InGaAs/InAlAs SPAD。该SPAD采用InP基底,1700 nm InGaAs作为吸收层,1000 nm InAlAs为倍增层。对该探测器进行了不同温度下击穿电压的测试,如图5所示。由图中可知InAlAs SPAD的温度系数约为50 mV/K,小于InP材料的温度系数约100 mV/K。运行于门控模式下,对1550 nm的光,温度为210 K,探测效率为26%,暗计数率为10⁸ Hz。

2021年,新加坡国立大学设计制造了能够抑制表面漏电流和过早击穿的三台面InGaAs/InAlAs SPAD,结构如图6所示。该InGaAs/InAlAs SPAD在150~270 K的范围内,测得击穿电压的温度系数为37.4 mV/K。在门控模式下,门控重复频率为15 kHz、脉冲宽度(半峰全宽)为20 ns、幅度为10 V的高斯脉冲,对于1550 nm的光,在240 K时探测效率为35%,暗计数率为3.3×10⁷ Hz。
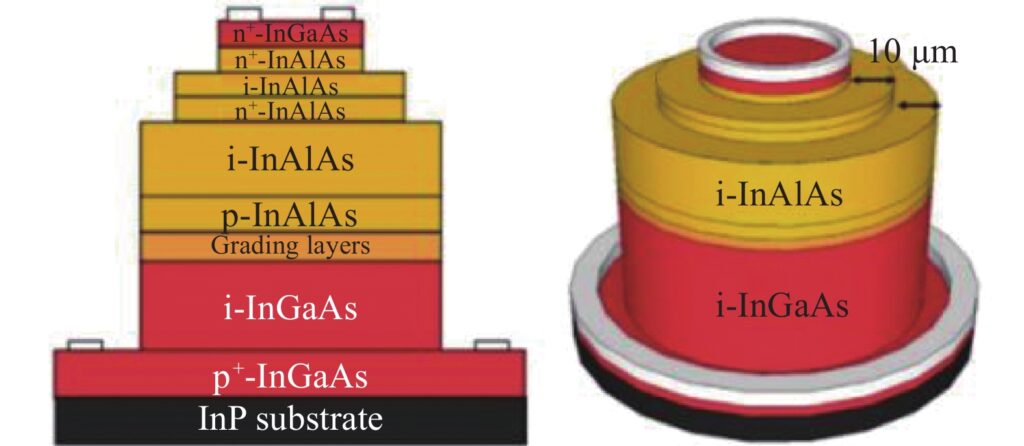
同年,新加坡国立大学通过低温片间键合技术,首次在一个共同的SiO₂平台上集成光栅耦合器、波导耦合器以及三台面InGaAs/InAlAs SPADs,如图7所示。对于1550 nm的光,在门控频率为15 kHz,门宽为20 ns的门控模式下,温度为220 K,获得探测效率约22%,暗计数率为8.6×10⁵ Hz。
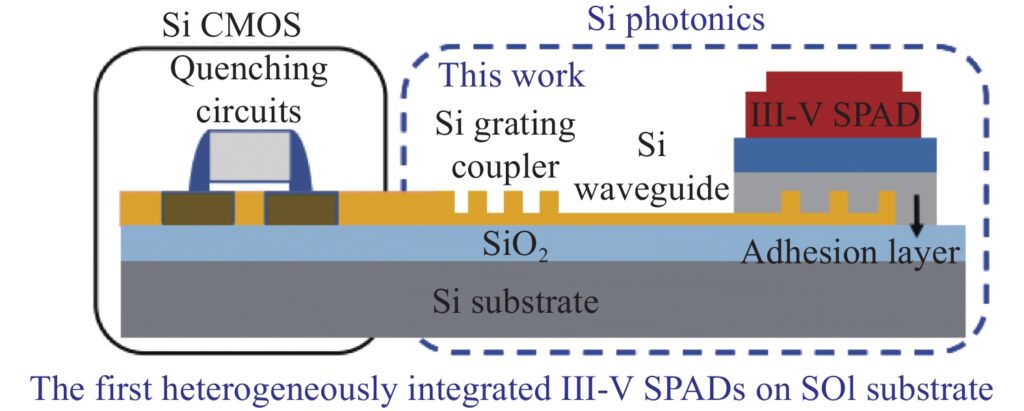
2022年,华中科技大学制造了平面InGaAs/InAlAs SPAD,器件截面图如图8所示,吸收层为1000 nm厚的未掺杂InGaAs,倍增层为200 nm厚的未掺杂InAlAs。对1550 nm的光,在门控频率为100 MHz的正弦门控模式下,温度为290 K,探测效率为10.4%,暗计数率为3.1 MHz。
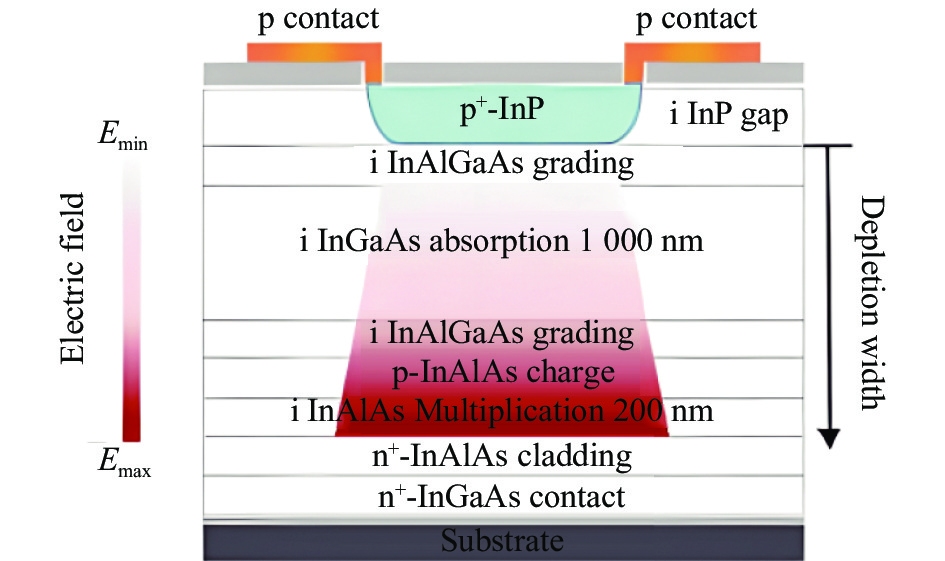
AlInAlAsSb数字合金雪崩光电二极管
GaSb基的AlxIn1−xAsySb1−y数字合金材料通过调整AlxIn1−xAsySb1−y中Al、Sb的成分可调整材料带隙,有望制成高性能的雪崩光电二极管。
2018年,美国弗吉尼亚大学制造了分离吸收、电荷、倍增(SACM)型的Al0.7In0.3As0.3Sb0.7/Al0.4In0.6As0.3Sb0.7雪崩光电二极管,结构图及内部电场分布图如图9所示。室温条件下器件处于95%击穿时,暗电流约为120 nA,与AlInAs/InGaAs APDs相当。将吸收层厚度调整为3 μm并在顶面上添加抗反射涂层,对于1550 nm的光实现了大于80%的量子效率。
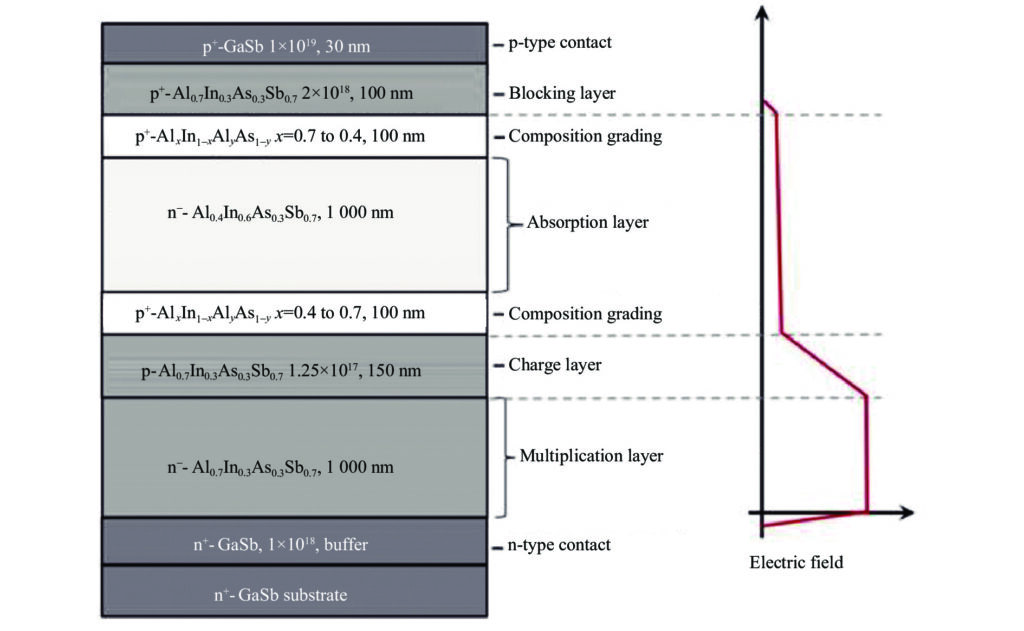
2020年,中国科学院半导体研究所设计并制备了分离吸收、渐变、电荷和倍增(SAGCM)型的AlInAsSb数字合金雪崩光电二极管,结构图如图10所示。在室温下,该器件在击穿前获得的稳定增益高达100,95%击穿电压时暗电流密度为0.95 mA/cm²。
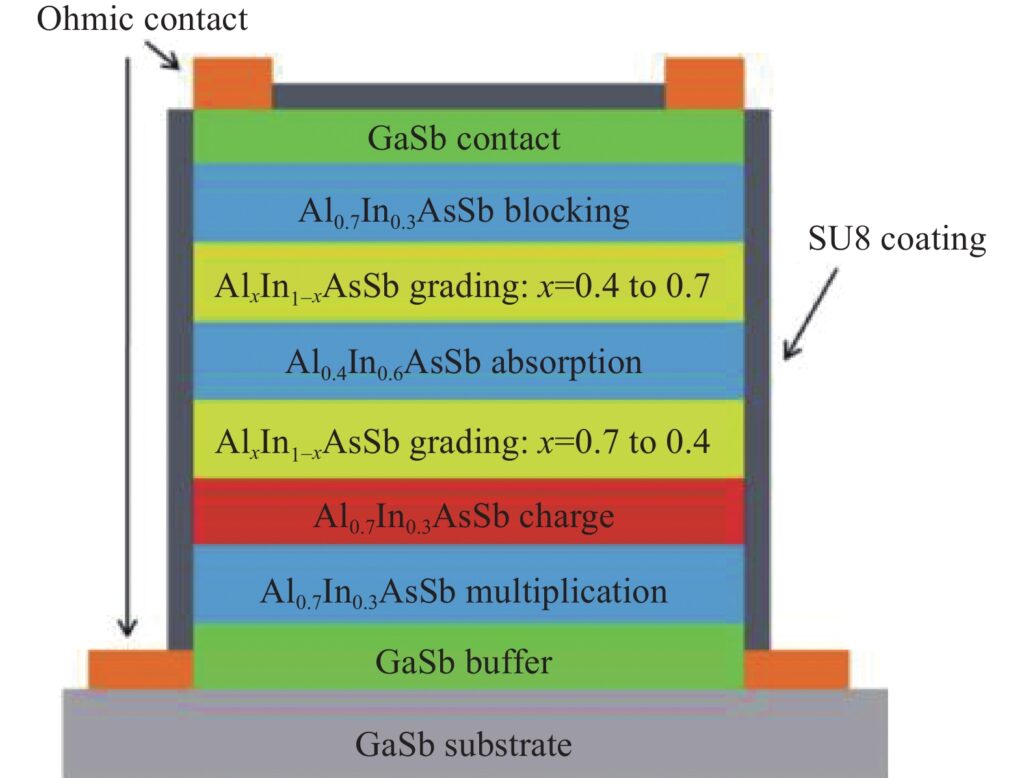
Sb基InAlAsSb合金材料制备的雪崩光电二极管具有与Si相当的低过剩量噪声因子,另外具有增益稳定、带隙可调、室温下暗电流密度低等优势,是发展高性能短波红外单光子探测器的一个重要材料选择。
结束语
近10年国内外研究团队通过优化器件结构、制备工艺以及雪崩信号提取电路显著提高了InP/InGaAs SPAD的性能,高探测效率、低暗计数率、室温InP/InGaAs短波红外单光子探测器获得快速发展。提高工作温度到室温或零度以上高温,是降低后脉冲的一个有效解决途径,同时可显著减小封装体积、降低成本。具有更小温度系数、带隙更宽且与吸收层InGaAs晶格匹配的InGaAs/In0.52Al0.48As SPAD,其探测效率、暗计数率目前不如InP/InGaAs SPAD,需要进一步改进提高。随着对三维成像的巨大发展需求,单光子焦平面阵列在规格和性能方面的提升是目前单光子探测器研究的一个重要工作。InAl-AsSb合金材料制备的雪崩光电二极管显示了较高的量子效率和稳定的雪崩增益,有望应用于高性能短波红外单光子探测器制备。
该项研究获得量子保密通信关键技术研究与开发(2018ZI002)和云南贵金属实验室科技计划项目(YPML-2022050220)的资助和支持。
论文信息:
DOI: 10.3788/IRLA20220908

