红外探测器被广泛应用于红外侦查、预警、制导、遥感等领域。近些年来,随着应用需求的不断牵引,红外探测器在保持高空间分辨率、高温度灵敏度的同时,还需兼顾向小型化、集成化的发展。传统的单片式信号处理电路在极限性能、功能集成度方面已难以满足未来红外系统的发展需求,基于三维集成技术的红外探测器逐步成为解决方案之一。
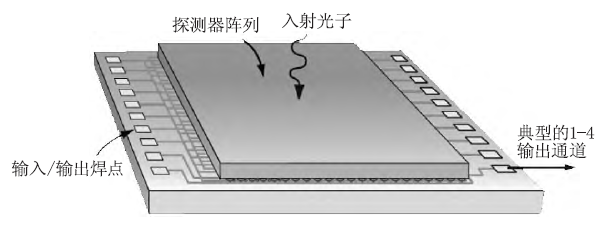
三维集成技术可分为三维晶圆级封装、基于三维中介层(interposer)的集成、三维堆叠式集成电路(3D staked IC,3D-SIC)、单片三维集成电路、三维异构集成等。传统的二维电路结构限制了像元级电路功能,三维电路集成显示出了其不受像元尺寸限制的优越性。三维集成电路将允许在相互独立的层内布局模拟电路和数字电路,这就可以充分利用模拟和数字电路各自的最佳设计规则和工艺技术,从而降低噪声、功耗并且提高产出率。
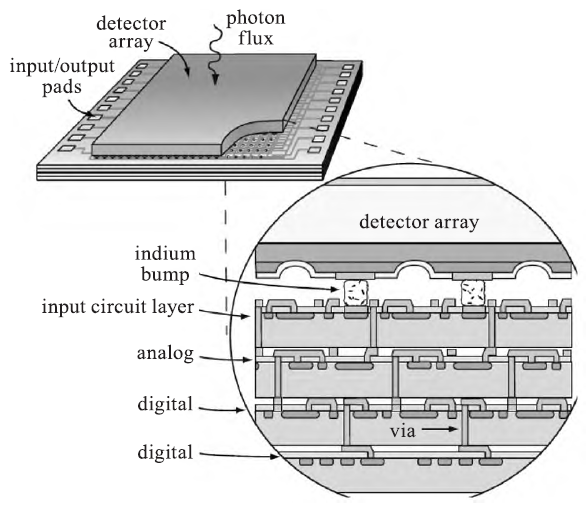
据麦姆斯咨询报道,近期,华北光电技术研究所喻松林研究员课题组在《激光与红外》期刊上发表了以“三维集成技术在红外探测器中的应用”为主题的文章。喻松林长期从事航天工程用红外技术创新探索、技术攻关、工程研制和自主可控技术平台建设。
这项研究对微电子器件三维集成技术进行了总结介绍,列举了国外相关研究机构利用三维集成技术研制红外探测器的进展,探讨了三维集成技术在红外探测器研制中面临的挑战。
红外焦平面探测器芯片由光电二极管阵列和读出电路芯片互连形成。根据互连形式可以分为两种,其一是采用In柱的互连结构,该结构是国内外绝大多数研究机构的技术方案;其二是采用通孔的互连结构。红外探测器中的三维集成可以分为读出电路的三维集成以及探测器的三维集成,由于摒弃了In柱互连,后者集成度更高。但是无论哪一种集成结构,采用通孔互连都是必备的技术途径。

随着光电系统应用需求的牵引,红外探测器正在向着缩小体积、重量和功耗,同时提高功能集成度的方向发展。采用三维集成技术实现多电路集成,可突破传统单片读出电路对红外系统性能和功能的限制,提高系统极限性能、扩展系统功能并且提高其集成度,满足对远距离弱小目标探测、高精度激光雷达成像等需求。
国外研究机构开发了各自适用的三维集成工艺,已经完成了主被动成像探测、高性能红外探测器、片上相机等原理样品的研制,相关测试结果表明,三维集成技术在提高红外探测器极限性能、提升功能集成度方面可发挥重要作用,突破该技术将有助于缩小红外探测器系统体积重量和功耗,提升红外探测器系统灵敏度、动态范围等指标,提升红外探测器片上处理能力,是未来红外探测器技术发展的重要方向之一。
目前,三维集成技术在制冷型红外探测器中已经获得了初步验证,不少研究机构均完成了各自的集成工艺开发,集成过程的主要难点包括:
(1)集成方式:减薄、表面金属沉积、对准标记等工艺可以晶圆级操作,提高效率;多层电路集成时,采用芯片级集成,可以提前选定合格芯片,避免晶圆集成时带来的良品率降低问题。但是,对于芯片级集成,引入了更多的手工操作,因此颗粒污染等控制难度增加。
(2)电路减薄:晶圆级减薄,要对晶圆边缘进行研磨,避免减薄过程中裂片;对减薄过程以及减薄后硅的厚度进行测试,保证晶圆级厚度可控;减薄后芯片厚度很小,易出现弯曲和变形。综上,在减薄电路芯片操控上需开发对应的工艺。
(3)电路键合:考虑到键合精度影响TSV的对准,因此要求键合精度微米量级,像元越小,要求越高,对于30μm间距的器件,对准精度要保持在3μm以内。对于工作在低温环境的红外探测器,还要求键合具备良好的可靠性,因此,需考虑电路之间的键合强度、键合应力,这对键合材质提出了较高要求。
(4)TSV制备:硅基电路上的TSV工艺相对成熟,但是对于工作在低温环境的红外探测器,在TSV制备中,应当考虑大量TSV中金属引入的应力。集成密度增加意味着像元间距缩小,最小像元间距受到TSV对准精度和全局金属焊盘宽度的综合影响。
该研究第一作者为华北光电技术研究所高级工程师谭振,主要从事红外探测器芯片制备方面的研究工作。

